後工程の核となる『パッケージング技術』において高い評価を得ており独自の『生産技術』と豊かな経験に基づく少ピン小型低背パッケージを軸にお客様の多様なニーズにお応えします。
また、各種環境規制に対応した鉛フリーなど環境対応も万全です。
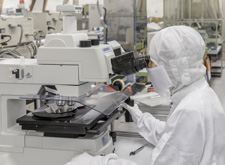
ウェハ加工技術
お客様より支給していただいたウェハで当社ではSiウェハ、GaAsウェハの両方の加工技術を有しております。
SiウェハについてはブレードダイシングGaAsウェハについてはポイントスクライブによるカット方式を採用しており高歩留まりでの作業が可能であります。
又、自動外観装置によりペレット検査も可能です。
- ウェハサイズ
- Max:8インチΦ
- ウェハ材質
- Si/GaAs
GaAsウェハのポイントスクライブの様子
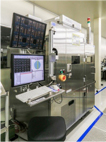
ウェハ外観装置
ダイボンド技術
熱硬化による接合、ペーストによる接合、金属材料による接合技術を有しており、お客様のニーズに合わせた高精度ダイボンディングが可能です。
また、薄小チップ対応が弊社の技術の特徴です。
- チップサイズ
- Min:0.27×0.23mm/Max:5.7×1.0mm
- ダイボンド精度
- x:±38um/y:±38um
- ダイボンド材料
- Agペースト/AuSnソルダー/PhSnソルダー
GaAsウェハのダイボンドの様子
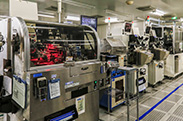
フープラインの外観
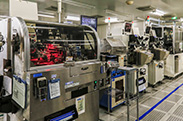
フープラインの外観
ワイヤボンド技術
自動によるNTCボンディングが主流であります。
線形小が弊社の特徴であり、Au、Ag、Cuワイヤを使用したワイヤボンディング技術を提供できます。
| 材質 | Au | PdコートCu |
| 線径 | 18um~38um | 20um |
| 精度 | x:±2.5um/y:2.5um |

ワイヤボンド設備
中空封入技術
従来のフルモールド技術に加えて、弊社独自の2重モールド構造、中空モールド構造を形成する技術を有しております。これにより、半導体チップのRF性能を最大限に引き出し、かつ、低コストな製品を実現します。

中空パッケージの構造


